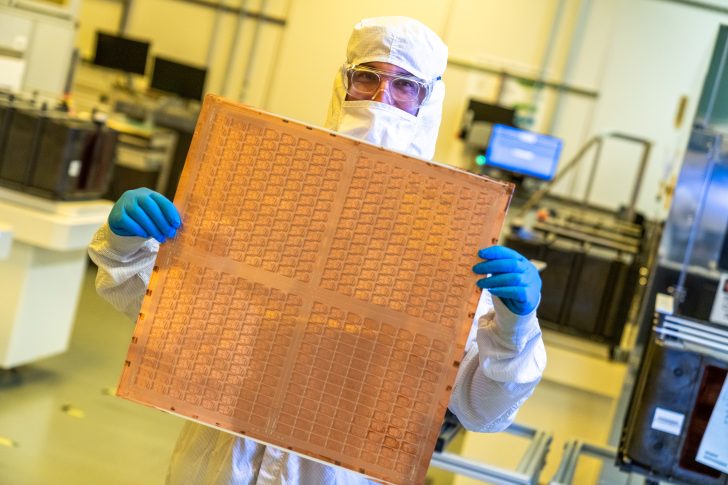
Компанія Amkor стверджує, що скляні підкладки, технологія пакування, яка розробляється Intel як альтернатива CoWoS, готується до комерціалізації протягом 3 років.
Партнер Intel, Amkor, прогнозує комерціалізацію скляних підкладок протягом трьох років
Передові технології пакування (Advanced Packaging) є ключовими для будь-якого великого виробника напівпровідників, оскільки чіпи стають все складнішими для задоволення зростаючих потреб у обчисленнях та пам’яті.
TSMC є найважливішим постачальником передових рішень для пакування у світі завдяки своїй технології CoWoS 2.5D. Сучасні вимоги до чіпів передбачають інтеграцію HBM (High Bandwidth Memory) та логічних чіпів в одному корпусі, і кількість використовуваних чіпів HBM агресивно зростає. Нещодавно OpenAI продемонструвала, як планує використовувати рішення, подібне до EMIB від Intel, щоб подолати поточні обмеження CoWoS.

Виробники напівпровідників, такі як TSMC, розширюють можливості чіпів, впроваджуючи нові рішення CoWoS для дизайнів 2029 року, що передбачають розміри понад 14 ретікулів і підтримують 24 чіпи HBM. Існують також більш просунуті рішення, як-от SoW-X, які масштабуватимуться до розмірів понад 40 ретікулів та підтримуватимуть понад 60 чіпів HBM. Це значно збільшить обчислювальну потужність чіпів наступного покоління, але такі рішення мають і певні проблеми.
Головні проблеми — це складність та вартість. З постійним масштабуванням дизайнів стає все складніше їх розробляти. Ці дизайни також створюють значні термічні та механічні навантаження, що може призвести до деформації. Крім того, час виробництва чіпа збільшується з використанням процесів на основі RDL (Redistribution Layer), сягаючи понад місяць.
Це створює вузькі місця в екосистемі напівпровідників стосовно продуктивності, підкладок, управління температурою, технологій з’єднання та структур передачі даних. Для подолання цих проблем технологія скляних підкладок розглядається як життєздатна альтернатива.

Під час конференції Elec, що проходила в Сеулі, Корея, керівник команди Amkor Technology, Ю Дон-су, заявив, що скляні підкладки забезпечують значно кращу термічну стабільність та опір деформації порівняно з традиційними органічними підкладками.
“Раніше були сумніви щодо того, чи зможуть скляні підкладки витримати навантаження, що виникають під час пакування, але технологічна стабільність забезпечується”, – зазначив керівник команди Ю. “Ми очікуємо, що вони будуть комерціалізовані протягом трьох років”.
То Дон-су – Керівник команди Amkor Technology, за матеріалами The Elec
Amkor вже є ключовим партнером Intel у розробці скляних підкладок, і великі компанії виявили інтерес до технології наступного покоління, яка змінить основу бізнесу з виробництва чіпів. Intel вже представила свої перші “скляні” підкладки, що використовують передову технологію пакування EMIB для живлення продуктів штучного інтелекту наступного покоління.
Проект скляних підкладок був започаткований під керівництвом попереднього генерального директора Intel, Пета Гелсінгера. Були повідомлення про те, що Intel може відмовитися від проекту, але нинішній генеральний директор Intel, Ліп-Бу Тан, виявив зацікавленість у його продовженні.

Три роки – це невеликий термін у загальному контексті, і якщо скляні підкладки виправдають очікування, то підрозділ Intel Foundry має шанс стати одним з провідних центрів виробництва чіпів для світу ШІ.
Джерело новин: The Elec

Про автора: Хасан Муджтаба, інженер-програміст за освітою та ентузіаст ПК за покликанням, є старшим редактором розділу апаратного забезпечення Wccftech. Маючи багаторічний досвід роботи в галузі, він спеціалізується на глибокому технічному аналізі архітектур ЦП та ГП наступного покоління, материнських плат та систем охолодження. Його робота включає не лише найсвіжіші новини про майбутні технології, але й всебічні огляди та тестування.
Слідкуйте за Wccftech на Google, щоб отримувати більше новин у своїх стрічках.
Пропозиція дня


Подальше читання

SK hynix перевіряє стек HBM з 12 чіпів, але не розкриває показники виходу, поки триває гонка за ШІ-пам’яттю HBM4
Раміш Зафар
Google, ймовірно, є великим клієнтом Intel Foundry, використовуватиме передову упаковку EMIB для TPU наступного покоління
Хасан Муджтаба
3D X-DRAM досягла рівня Proof-of-Concept, замінюючи HBM з щільністю в 10 разів вищою за традиційну DRAM та високою видовістю
Хасан Муджтаба
Ключовий постачальник CoWoS від TSMC подає до суду на колишнього генерального директора, заперечуючи передачу технологій до Китаю
Хасан Муджтаба
Чи варто купувати? (Порада ІТ-Блогу): Технологія скляних підкладок від Intel, яку підтримує Amkor, обіцяє стати значним проривом у пакуванні напівпровідників, пропонуючи кращу термічну стабільність та масштабованість порівняно з поточними рішеннями. Якщо технологія виправдає очікування та буде впроваджена вчасно, це може суттєво зміцнити позиції Intel у сфері виробництва чіпів для ШІ, але наразі це є інвестицією в майбутнє, а не пропозицією з готовим продуктом для масового ринку.
Оригінал статті: wccftech.com
